Publications
Journal Articles
2026
Deformation behavior of sintered Ag in relation to densification during spherical indentation creep test
Seonghwan Park*, Hiroaki Tatsumi, Hiren R. Kotadia, Hiroshi Nishikawa*
Journal of Materials Research and Technology, XX, xxxx (2026)
doi: 10.1016/j.jmrt.2026.04.203
Non-destructive orientation tracking of individual β-Sn grains in die-attach solder joints
Jaemyung Kim*, Yujiro Hayashi, Hiroaki Tatsumi, Hiroshi Nishikawa, Makina Yabashi
Journal of Synchrotron Radiation, 33, 617 (2026)
doi: 10.1107/S1600577526001475
Effect of surface-modified nanoparticles on microstructure and hardness of low-temperature solder alloys
Shunya Nitta*, Hiroaki Tatsumi, Atsushi M Ito, Arimichi Takayama, Takeshi Wada, Hidemi Kato, Hiroshi Nishikawa*
Surfaces and Interfaces, 86, 108793 (2026)
doi: 10.1016/j.surfin.2026.108793
Study on pore features in sintered die-attach microstructures based on machine learning
Runhua Gao*, Hiroaki Tatsumi, Takanori Kobatake, Minoru Ueshima, Hiroshi Nishikawa
Scientific Reports, 16, 8803 (2026)
doi: 10.1038/s41598-026-39207-x
Effect of lotus-type porous Cu on reliability of Ag-sintered joints during thermal cycling
Minsu Kim, Hiroaki Tatsumi, Sang-Wook Kim, Ji-Hyun Kim, Soong-Keun Hyun*, Hiroshi Nishikawa*
Materials Letters: X, 27, 100264 (2026)
doi: 10.1016/j.mlblux.2026.100264
 Microstructure and thermal performance of lotus-type porous Cu/solder composite joints
Microstructure and thermal performance of lotus-type porous Cu/solder composite joints
Kana Hirase, Hiroaki Tatsumi*, Hiroshi Isono, Takuya Ide, Hidemi Kato, Hiroshi Nishikawa
Journal of Materials Research and Technology, 41, 3825 (2026)
doi: 10.1016/j.jmrt.2026.02.028
2025
 Ion milling-enhanced preferential growth of CoSn3 for crystallographic orientation control of Sn on polycrystalline Co substrates
Ion milling-enhanced preferential growth of CoSn3 for crystallographic orientation control of Sn on polycrystalline Co substrates
Xinjie Wang*, Hiroaki Tatsumi*, Chia-Lin Li, Jyh-Wei Lee, Hiroshi Nishikawa
Materials & Design, 261, 115329 (2026)
doi: 10.1016/j.matdes.2025.115329
 Experimental and first-principles insights into Ti-mediated Cu–Si3N4 interfaces for high-reliability electronic substrates
Experimental and first-principles insights into Ti-mediated Cu–Si3N4 interfaces for high-reliability electronic substrates
Hiroaki Tatsumi*, Shunya Nitta, Atsushi M. Ito, Arimichi Takayama, Makoto Takahashi, Seongjae Moon, Eiki Tsushima, Hiroshi Nishikawa
Acta Materialia, 304, 121813 (2026)
doi: 10.1016/j.actamat.2025.121813
高圧粉末圧縮法によるCu-SnAgCu成形シートを用いた液相拡散接合層の信頼性評価
坂本 一三*, 巽 裕章, 西川 宏
スマートプロセス学会誌, 14, 301 (2025)
doi: 10.7791/jspmee.14.301
Orbital validation for tin whisker suppression by conformal coating
Shinichiro Ichimaru*, Tsuyoshi Nakagawa, Norio Nemoto, Katsuaki Suganuma, Hiroaki Tatsumi, Hiroshi Nishikawa
Microelectronics Reliability, 174, 115888 (2025)
doi: 10.1016/j.microrel.2025.115888
Lead whisker growth characteristics on satellites in Earth orbit
Shinichiro Ichimaru*, Tsuyoshi Nakagawa, Norio Nemoto, Katsuaki Suganuma, Hiroaki Tatsumi, Hiroshi Nishikawa
Materialia, 43, 102470 (2025)
doi: 10.1016/j.mtla.2025.102470
Effect of copper on interfacial reaction and microstructure of soldering on aluminum substrate
Jiahui Li*, Yu-An Shen, Hiroaki Tatsumi, Hiren Kotadia, Runhua Gao, Hiroshi Nishikawa*
Journal of Materials Research and Technology, 37, 3533 (2025)
doi: 10.1016/j.jmrt.2025.07.059
Direct formation of Cu nano-dendritic structure on substrate by dynamic hydrogen bubble template for organic-free sintered Cu-to-Cu bonding
Ji-Hyun KIM*, Hiroaki Tatsumi, Hiroshi Nishikawa*
Surfaces and Interfaces, 62, 106268 (2025)
doi: 10.1016/j.surfin.2025.106268
Interfacial reaction and IMC growth kinetics at the Bi2Te3/Ag interface during isothermal aging
SeongWoo Pak*, Hiroaki Tatsumi, Jianhao Wang, Albert T. Wu, Hiroshi Nishikawa*
Intermetallics, 179, 108686 (2025)
doi: 10.1016/j.intermet.2025.108686
 Atomistic behavior of Cu–Cu solid-state bonding in polycrystalline Cu with high-density boundaries
Atomistic behavior of Cu–Cu solid-state bonding in polycrystalline Cu with high-density boundaries
Hiroaki Tatsumi*, C. R. Kao, Hiroshi Nishikawa
Materials & Design, 250, 113576 (2025)
doi: 10.1016/j.matdes.2024.113576
2024
Low-temperature soldering using Sn/Bi electrodeposited bilayer
Wei-Li Wang, Sheng-Jye Cherng, Yu-Ting Huang, Runhua Gao, Hiroaki Tatsumi, Hiroshi Nishikawa*, Chih-Ming Chen*
Materials Science in Semiconductor Processing, 186, 109056 (2025)
doi: 10.1016/j.mssp.2024.109056
Microstructure and Bonding Properties of Transient Liquid-Phase Bonding using Cu–SnAgCu Molded Sheets by High Pressure Powder Compression
Ichizo Sakamoto*, Doojin Jeong, Hiroaki Tatsumi, Hiroshi Nishikawa
Journal of Electronic Materials, 54, 773 (2024)
doi: 10.1007/s11664-024-11524-9
Study of the Characteristics and Growth of Tin Whiskers in Orbit
Shinichiro Ichimaru*, Tsuyoshi Nakagawa, Norio Nemoto, Katsuaki Suganuma, Hiroaki Tatsumi, Hiroshi Nishikawa
Microelectronics Reliability, 162, 115523 (2024)
doi: 10.1016/j.microrel.2024.115523
Thermal Decomposition Temperature Dependent Bonding Performance of Ag Nanostructures Derived from Metal-Organic Decomposition
Chuncheng Wang, Hiroaki Tatsumi, Hiroshi Nishikawa*
Journal of Materials Science, 59, 19038 (2024)
doi: 10.1007/s10853-024-10250-1
Substrate-Dependent Sintering Mechanism of Ag Nanostructures Derived from Ag-Based Complex
Chuncheng Wang, Hiroaki Tatsumi, Hiren Kotadia, Hiroshi Nishikawa*
ACS Applied Electronic Materials, 6, 7360 (2024)
doi: 10.1021/acsaelm.4c01253
Study on Thermal Cycling Reliability of Epoxy-Enhanced SAC305 Solder Joint
Peng Zhang, Songbai Xue*, Lu Liu, Jianhao Wang, Hiroaki Tatsumi, Hiroshi Nishikawa
Polymers, 16, 2597 (2024)
doi: 10.3390/polym16182597
Cu–Ni合金めっき膜を用いた金属/CFRTP接合部の疲労特性評価
小林 竜也*, 巽 裕章, 山崎 康平, 岡下 諒哉, 荘司 郁夫
銅と銅合金, 63, 176 (2024)
doi: 10.34562/jic.63.1_176
[解説記事] マイクロ接合向け固相接合挙動に関する分子動力学シミュレーション
巽 裕章
溶接学会誌, 93, 149 (2024)
doi: 10.2207/jjws.93.149
A comparative numerical study of thermo-mechanical behavior among various IMC joints under thermal cycling condition
Xunda Liu*, Hiroaki Tatsumi, Hiroshi Nishikawa*
Journal of Smart Processing, 13, 83 (2024)
doi: 10.7791/jspmee.13.83
Transparent Liquid Ag-Based Complex for the Facile Preparation of Robust Sintered Ag Joints in Power Devices
Chuncheng Wang, Hiroaki Tatsumi, Liang Xu*, Tao Zhao, Pengli Zhu, Rong Sun, Hiroshi Nishikawa*
ACS Applied Electronic Materials, 6, 1718 (2024)
doi: 10.1021/acsaelm.3c01629
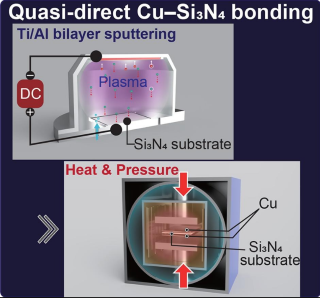 Quasi-direct Cu–Si3N4 bonding using multi-layered active metal deposition for power-module substrate
Quasi-direct Cu–Si3N4 bonding using multi-layered active metal deposition for power-module substrate
Hiroaki Tatsumi*, Seongjae Moon, Makoto Takahashi, Takahiro Kozawa, Eiki Tsushima, Hiroshi Nishikawa
Materials & Design, 238, 112637 (2024)
doi: 10.1016/j.matdes.2024.112637
Interfacial reactions between In and Ag during solid liquid interdiffusion process
Xunda Liu*, Fupeng Huo, Jianhao Wang, Hiroaki Tatsumi, Zhi Jin, Zhong Chen, Hiroshi Nishikawa*
Surfaces and Interfaces, 45, 103844 (2024)
doi: 10.1016/j.surfin.2024.103844
Analysis of microstructures and fractures in Ag–In transient liquid phase bonded joints
Xunda Liu*, Hiroaki Tatsumi, Jianhao Wang, Zhi Jin, Zhong Chen, Hiroshi Nishikawa*
Materials Science and Engineering: A, 892, 146045 (2024)
doi: 10.1016/j.msea.2023.146045
2023
Sn-Bi-Zn-In合金のBi含有量が微細組織と機械的特性に及ぼす影響
中脇 啓貴, 巽 裕章, 新田 隼也, Chih-han Yang, Shih-kang Lin, 西川 宏
溶接学会論文集, 41, 348 (2023)
doi: 10.2207/qjjws.41.348
 Impact of crystalline orientation on Cu–Cu solid-state bonding behavior by molecular dynamics simulations
Impact of crystalline orientation on Cu–Cu solid-state bonding behavior by molecular dynamics simulations
Hiroaki Tatsumi*, C.R. Kao, Hiroshi Nishikawa
Scientific Reports, 13, 23030 (2023)
doi: 10.1038/s41598-023-50427-3
Thermomechanical Properties of Zeta (Ag3In) Phase
Xunda Liu*, Hiroaki Tatsumi, Zhi Jin, Zhong Chen, Hiroshi Nishikawa*
Materials, 16, 7115 (2023)
doi: 10.3390/ma16227115
Strength-enhanced Sn–In low-temperature alloy with surface-modified ZrO2 nanoparticle addition
Shunya Nitta*, Hiroaki Tatsumi, Hiroshi Nishikawa*
Journal of Materials Science: Materials in Electronics, 34, 2066 (2023)
doi: 10.1007/s10854-023-11344-3
Influence of Isothermal Aging on Microstructure and Shear Property of Novel Epoxy Composite SAC305 Solder Joints
Peng Zhang, Songbai Xue*, Lu Liu, Jianhao Wang, Hiroaki Tatsumi, Hiroshi Nishikawa
Polymers, 15, 4168 (2023)
doi: 10.3390/polym15204168
Fabrication and thermo-mechanical properties of Ag9In4 intermetallic compound
Xunda Liu*, Hiroaki Tatsumi, Zhi Jin, Zhong Chen, Hiroshi Nishikawa*
Intermetallics, 162, 108028 (2023)
doi: 10.1016/j.intermet.2023.108028
Comparative Study of Sn-based Solder Wettability on Aluminum Substrate
Jiahui Li*, Hiroaki Tatsumi, Hiroshi Nishikawa*
Quarterly Journal of the Japan Welding Society, 41, 26s (2023)
doi: 10.2207/qjjws.41.26a
Thermal conductivity and reliability reinforcement for sintered microscale Ag particle with AlN nanoparticles additive
Jianhao Wang*, Shogo Yodo, Hiroaki Tatsumi, Hiroshi Nishikawa*
Materials Characterization, 203, 113150 (2023)
doi: 10.1016/j.matchar.2023.113150
Reliability-enhanced microscale Ag sintered joint doped with AlN nanoparticles
Jianhao Wang*, Shogo Yodo, Hiroaki Tatsumi, Hiroshi Nishikawa*
Materials Letters, 349, 134845 (2023)
doi: 10.1016/j.matlet.2023.134845
The electromigration study of thin-film structured Sn3.5Ag and Ag using continuous observation and reliability enhancement approach
Zhi Jin*, Fupeng Huo, Duy Le Han, Xunda Liu, Hiroaki Tatsumi, Y.C. Chan, Hiroshi Nishikawa*
Thin Solid Films, 774, 139827 (2023)
doi: 10.1016/j.tsf.2023.139827
2022
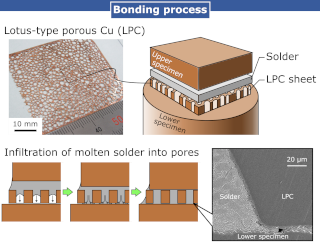 Anisotropic Highly Conductive Joints utilizing Cu-Solder Microcomposite Structure for High-Temperature Electronics Packaging
Anisotropic Highly Conductive Joints utilizing Cu-Solder Microcomposite Structure for High-Temperature Electronics Packaging
Hiroaki Tatsumi*, Hiroshi Nishikawa
Materials & Design, 223, 111204 (2022)
doi: 10.1016/j.matdes.2022.111204
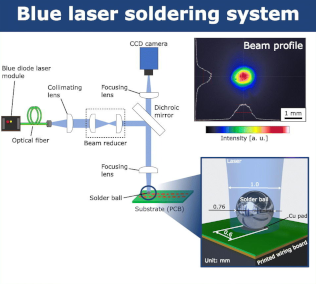 Highly Efficient Soldering of Sn-Ag-Cu Solder Joints using Blue Laser
Highly Efficient Soldering of Sn-Ag-Cu Solder Joints using Blue Laser
Hiroaki Tatsumi*, Seiji Kaneshita, Yuki Kida, Yuji Sato, Masahiro Tsukamoto, Hiroshi Nishikawa*
Journal of Manufacturing Processes, 82, pp.700–707 (2022)
doi: 10.1016/j.jmapro.2022.08.025
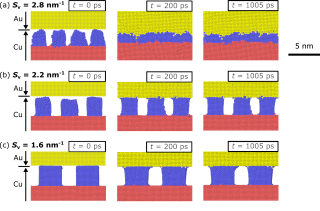 Solid-State Bonding Behavior between Surface-Nanostructured Cu and Au: A Molecular Dynamics Simulation
Solid-State Bonding Behavior between Surface-Nanostructured Cu and Au: A Molecular Dynamics Simulation
Hiroaki Tatsumi*, C. R. Kao, Hiroshi Nishikawa
Scientific Reports, 12, pp.12755 (2022)
doi: 10.1038/s41598-022-17119-w
2021
Pressureless sinter joining of bare Cu substrates under forming gas atmosphere by surface-oxidized submicron Cu particles
Daiki Yamagiwa, Tomoki Matsuda*, Hideki Furusawa, Kenji Sato, Hiroaki Tatsumi, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
Journal of Materials Science: Materials in Electronics, 32, pp.19031–19041 (2021)
doi: 10.1007/s10854-021-06418-z
2019
 Deformation Behavior of Transient Liquid-Phase Sintered Cu-Solder-Resin Microstructure for Die-Attach
Deformation Behavior of Transient Liquid-Phase Sintered Cu-Solder-Resin Microstructure for Die-Attach
Hiroaki Tatsumi*, Hiroshi Yamaguchi, Tomoki Matsuda, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
Applied Sciences, 9, pp.3476–3490 (2019)
doi: 10.3390/app9173476
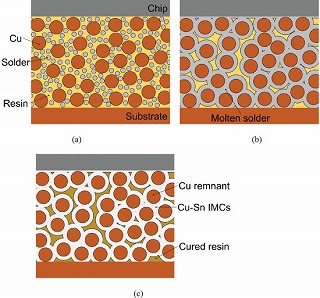 Evaluation of Stiffness-Reduced Joints by Transient Liquid-Phase Sintering of Copper-Solder-Resin Composite for SiC Die-Attach Applications
Evaluation of Stiffness-Reduced Joints by Transient Liquid-Phase Sintering of Copper-Solder-Resin Composite for SiC Die-Attach Applications
Hiroaki Tatsumi*, Adrian Lis, Hiroshi Yamaguchi, Yoshihiro Kashiba, Akio Hirose
IEEE Transactions on Components, Packaging and Manufacturing Technology, 9, pp.2111-2121 (2019)
doi: 10.1109/TCPMT.2019.2916053
Reliability and Temperature Resistance of Solder–Metallic Mesh Composite Joints
Adrian Lis*, Hiroaki Tatsumi, Tomoki Matsuda, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
Journal of Electronic Materials, 48, pp.3699–3712 (2019)
doi: 10.1007/s11664-019-07130-9
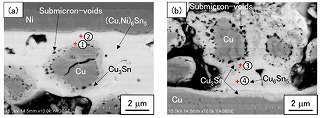 Evolution of Transient Liquid-Phase Sintered Cu-Sn Skeleton Microstructure During Thermal Aging
Evolution of Transient Liquid-Phase Sintered Cu-Sn Skeleton Microstructure During Thermal Aging
Hiroaki Tatsumi*, Adrian Lis, Hiroshi Yamaguchi, Tomoki Matsuda, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
Applied Sciences, 9, pp.157–168 (2019)
doi: 10.3390/app9010157
2018
 Bonding through novel solder-metallic mesh composite design
Bonding through novel solder-metallic mesh composite design
Adrian Lis*, Hiroaki Tatsumi, Tomoki Matsuda, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
Materials & Design, 160, pp.475-485 (2018)
doi: 10.1016/j.matdes.2018.09.017
2016
Impact of Metallurgical and Mechanical Properties of Sintered Silver Nanoparticles on Die-attach Reliability of High-temperature Power Modules
Hiroaki Tatsumi*, Sho Kumada, Atsushi Fukuda, Hiroshi Yamaguchi, Yoshihiro Kashiba
Journal of Microelectronics and Electronic Packaging, 13, pp.121-127 (2016)
doi: 10.4071/imaps.506
[Review paper] Packaging Technologies for High-Temperature Power Semiconductor Modules
Yasunari Hino, Nobuo Yokomura, Hiroaki Tatsumi
Mitsubishi Electric ADVANCE, 149, pp.18-20 (2016)
Link
2014
[解説記事] 高耐熱パワー半導体モジュールパッケージング要素技術
日野 泰成,長谷川 滋,山田 浩司,巽 裕章,横村 伸緒,畑中 康道
三菱電機技報, 88, pp.313-316 (2014)
Link
2012
Interfacial Bonding Behavior between Silver Nanoparticles and Gold Substrate Using Molecular Dynamics Simulation
Tomo Ogura*, Masumi Nishimura, Hiroaki Tatsumi, Wataru Takahara, Akio Hirose
Materials Transactions, 53, pp.2085-2090 (2012)
doi: 10.2320/matertrans.MB201201
Low Temperature Sintering Bonding Process Using Ag Nanoparticles Derived from Ag2O for Packaging of High-temperature Electronics
Akio Hirose*, Naoya Takeda, Hiroaki Tatsumi, Yusuke Akada, Tomo Ogura, Eiichi. Ide, Toshiaki Morita
Materials Science Forum, 706-709, pp.2962-2967 (2012)
doi: 10.4028/www.scientific.net/MSF.706-709.2962
2011
Evaluation of Interfacial Bonding Utilizing Ag2O-Derived Silver Nanoparticles using TEM Observation and Molecular Dynamics Simulation
Tomo Ogura*, Masumi Nishimura, Hiroaki Tatsumi, Naoya Takeda, Wataru Takahara, Akio Hirose
The Open Surface Science Journal, 3, pp.55-59 (2011)
doi: 10.2174/1876531901103010055
2009
A Novel Metal-to-Metal Bonding Process through In-situ Formation of Ag Nanoparticles Using Ag2O Microparticles
Akio Hirose*, Hiroaki Tatsumi, Naoya Takeda, Yusuke Akada, Tomo Ogura, Eiichi Ide, Toshiaki Morita
Journal of Physics: Conference Series, 165, pp.012074_1-6 (2009)
doi: 10.1088/1742-6596/165/1/012074
2008
Interfacial Bonding Mechanism Using Silver Metallo-Organic Nanoparticles to Bulk Metals and Observation of Sintering Behavior
Yusuke Akada*, Hiroaki Tatsumi, Takuto Yamaguchi, Akio Hirose, Toshiaki Morita, Eiichi Ide
Materials Transactions, 49, pp.1537-1545 (2008)
doi: 10.2320/matertrans.MF200805
2007
Sintering Mechanism of Composite Ag Nanoparticles and its Application to Bonding Process
Hiroaki Tatsumi*, Yusuke Akada, Takuto Yamaguchi, Akio Hirose
Advanced Materials Research, 26-28, pp.499-502 (2007)
doi: 10.4028/www.scientific.net/AMR.26-28.499
Books
標準マイクロソルダリング技術 第4版
一般社団法人日本溶接協会マイクロソルダリング教育委員会 (共著)
日刊工業新聞社 (2024/3/30)
ISBN: 978-4526083280
https://amzn.asia/d/hxDMGYc
International Conference Papers
X-ray Orientation Microscopy for Non-destructive Observation of Grain Boundaries in Die-attach Solder
Yujiro Hayashi, Jaemyung Kim, Makina Yabashi, Hiroaki Tatsumi
2026 International Conference on Electronics Packaging and Hybrid Bonding Symposium (ICEP-HBS 2026), pp.XX-XX (2026)
doi:
The role of densification on deformation behavior of sintered Ag during nanoindentation creep testing
Seonghwan Park, Hiroaki Tatsumi, Hiroshi Nishikawa
2026 International Conference on Electronics Packaging and Hybrid Bonding Symposium (ICEP-HBS 2026), pp.XX-XX (2026)
doi:
Microstructural Refinement and Solidification Behavior in Sn-In Composite Solders with NiO-Coated ZrO2 Nanoparticles
Shunya Nitta, Hiroaki Tatsumi, Atsushi M. Ito, Arimichi Takayama, Hiroshi Nishikawa
2026 International Conference on Electronics Packaging and Hybrid Bonding Symposium (ICEP-HBS 2026), pp.XX-XX (2026)
doi:
Morphology and Electrical Resistivity of Pyrolyzed Carbon Micro-architectures
Yu-Yen Chen, Hiroaki Tatsumi, Hiroshi Nishikawa
2026 International Conference on Electronics Packaging and Hybrid Bonding Symposium (ICEP-HBS 2026), pp.XX-XX (2026)
doi:
2025
Grain Orientation Analysis for Thermal Cycling Evaluation of Die-Attach Solder Joints
Hiroaki Tatsumi, Yujiro Hayashi, Jaemyung Kim, Makina Yabashi, Hiroshi Nishikawa
2025 25th European Microelectronics and Packaging Conference & Exhibition (EMPC), pp.1-5 (2025)
doi: 10.23919/EMPC63132.2025.11222564
Evaluations of Transient Liquid Phase Joints Using in-Coated Ag Sheet
Xunda Liu, Hiroaki Tatsumi, Zhi Jin, Hiroshi Nishikawa
2025 25th European Microelectronics and Packaging Conference & Exhibition (EMPC), pp.1-5 (2025)
doi: 10.23919/EMPC63132.2025.11222402
Regulating Sn Grain Orientations in Soldered Joints through CoSn3
Xinjie Wang, Hiroaki Tatsumi, Hiroshi Nishikawa
2025 International Conference on Electronics Packaging (ICEP2025), pp.25-26 (2025)
doi: 10.23919/ICEP-IAAC64884.2025.11002913
Glass to Glass Joint by Low Temperature Soldering using Localized Induction Heating Process
Chi Hsuan Lin, Hiroaki Tatsumi, Jenn Ming Song, Hiroshi Nishikawa
2025 International Conference on Electronics Packaging (ICEP2025), pp.27-28 (2025)
doi: 10.23919/ICEP-IAAC64884.2025.11003011
Non-destructive X-ray Orientation Mapping of Die-attach Solder for Thermal Cycling Test
Yujiro Hayashi, Jaemyung Kim, Makina, Yabashi, Hiroaki Tatsumi
2025 International Conference on Electronics Packaging (ICEP2025), pp.137-138 (2025)
doi: 10.23919/ICEP-IAAC64884.2025.11002970
Predictive Validity for Sintered Die-Attach Performance based on Cross-Sectional Morphology
Runhua Gao, Hiroaki Tatsumi, Takanori Kobatake, Minoru Ueshima, Hiroshi Nishikawa
2025 International Conference on Electronics Packaging (ICEP2025), pp.169-170 (2025)
doi: 10.23919/ICEP-IAAC64884.2025.11002894
Sintered Cu-to-Cu Joints using Cu Dendritic Structure Formed by a Dynamic Hydrogen Bubble Template with Cetyltrimethylammonium Bromide
Ji-Hyun Kim, Hiroaki Tatsumi, Hiroshi Nishikawa
2025 International Conference on Electronics Packaging (ICEP2025), pp.197-198 (2025)
doi: 10.23919/ICEP-IAAC64884.2025.11002961
2024
Creep Behavior of Low-temperature Sn-In Solder using Nanoindentation Test
Shunya Nitta, Hiroaki Tatsumi, and Hiroshi Nishikawa
2024 IEEE International 3D Systems Integration Conference (3DIC 2024), pp.XX-XX (2024)
doi: 10.1109/3DIC63395.2024.10830234
Joint Strength of Transient Liquid Phase Bonding Using Cu–SAC Molded Sheet
Ichizo Sakamoto, Doojin Jeong, Hiroaki Tatsumi, and Hiroshi Nishikawa
2024 International Conference on Electronics Packaging (ICEP2024), pp.41-42 (2024)
doi: 10.23919/ICEP61562.2024.10535614
Low Thermal Resistance Joint using Lotus-type Cu/Solder Composite
Hiroaki Tatsumi, Hiroshi Isono, Kana Hirase, Takuya Ide, and Hiroshi Nishikawa
2024 International Conference on Electronics Packaging (ICEP2024), pp.51-52 (2024)
doi: 10.23919/ICEP61562.2024.10535580
Ag Sintered Joints on ENIG Cu Substrates by an Ag-based Complex
Chuncheng, Wang, Hiroaki Tatsumi, and Hiroshi Nishikawa
2024 International Conference on Electronics Packaging (ICEP2024), pp.95-96 (2024)
doi: 10.23919/ICEP61562.2024.10535647
2023
Molecular Dynamics Simulation of Cu-Cu Solid-State Bonding under Various Bonding Parameters
Hiroaki Tatsumi, C.R. Kao, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.149-150 (2023)
doi: 10.23919/ICEP58572.2023.10129651
Failure Analysis of Joints Bonded by Ag-In Transient Liquid Phase Process during Shear Test
Xunda Liu, Hiroaki Tatsumi, Zhi Jin, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.25-26 (2023)
doi: 10.23919/ICEP58572.2023.10129705
The Influence of Bi Content on Joint Properties using Sn-Bi-Zn-In Alloy
Hiroki Nakawaki, Hiroaki Tatsumi, Chih-han Yang, Shih-kang Lin, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.209-210 (2023)
doi: 10.23919/ICEP58572.2023.10129655
Interfacial Intermetallic Compounds of Bi2Te3/Cu Joint using SAC305 Solder and Nano-Ag Paste
Seongwoo Pak, Hiroaki Tatsumi, Jianhao Wang, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.199-200 (2023)
doi: 10.23919/ICEP58572.2023.10129738
Microstructure and Property of Ag Sintered Joint Doping with AlN Nanoparticles
Jianhao Wang, Shogo Yodo, Hiroaki Tatsumi, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.145-146 (2023)
doi: 10.23919/ICEP58572.2023.10129686
Significant Consumption of Ni-P Layer in Ni-P/Sn-0.7Cu Solder Joints during Thermomigration
Satoshi Oya, Hiroaki Tatsumi, and Hiroshi Nishikawa
2023 International Conference on Electronics Packaging (ICEP2023), pp.81-82 (2023)
doi: 10.23919/ICEP58572.2023.10129736
2022
Mechanical properties of transient liquid phase bonded joints by using Ag-In sandwich structure
Xunda Liu*, Zhi Jin, Hiroaki Tatsumi, Hiroshi Nishikawa
24th Electronics Packaging Technology Conference (EPTC 2022), pp.71-75 (2022)
doi: 10.1109/EPTC56328.2022.10013239
Effect of isothermal aging on properties of In-48Sn and In-Sn-8Cu alloys
Duy Le Han*, Hiroaki Tatsumi, Fupeng Huo, Hiroshi Nishikawa
2022 IEEE 72nd Electronic Components and Technology Conference (ECTC), pp.2148-2152 (2022)
doi: 10.1109/ECTC51906.2022.00339
2018
Transient Liquid Phase Sintering Using Copper-Solder-Resin Composite for High- temperature Power Modules
Hiroaki Tatsumi*, Adrian Lis, Takeshi Monodane, Hiroshi Yamaguchi, Yoshihiro Kashiba, Akio Hirose
2018 IEEE 68th Electronic Components and Technology Conference (ECTC), pp.564–567 (2018)
doi: 10.1109/ECTC.2018.00089
Novel solder-mesh interconnection design for power module applications
Adrian Lis*, Hiroaki Tatsumi, Tomoki Matsuda, Tomokazu Sano, Yoshihiro Kashiba, Akio Hirose
International Conference and Exhibition on High Temperature Electronics (HiTEC), pp.57–62 (2018)
doi: 10.4071/2380-4491-2018-HiTEN-000057
2015
Impact of Metallurgical and Mechanical Properties of Sintered Silver Nanoparticles on Die-attach Reliability of High-temperature Power Modules
Hiroaki Tatsumi*, Sho Kumada, Atsushi Fukuda, Hiroshi Yamaguchi, Yoshihiro Kashiba
48th International Symposium on Microelectronics (IMAPS2015), pp.842-847 (2015)
doi: 10.4071/isom-2015-THP42
2009
A Novel Metal-to-metal Bonding Process Utilizing Low-temperature Sinterability of Ag2O-derived Ag Nanoparticles
Naoya Takeda*, Hiroaki Tatsumi, Yusuke Akada, Tomo Ogura, Eiichi Ide, Toshiaki Morita, Akio Hirose
International Conference on Electronics Packaging 2009 (ICEP), pp.760-765 (2009)
2008
Investigation of Bonding Mechanism of Ag Nanoparticles to Bulk Metals
Yusuke Akada*, Hiroaki Tatsumi, Takuto Yamaguchi, Akio Hirose, Toshiaki Morita, Eiichi Ide
The Second International Symposium on Smart Processing Technology, pp.187-190 (2008)
Domestic Conference Papers
2026
- 城 敦士,巽 裕章,西川 宏,“はんだ接合部エレクトロマイグレーション挙動の理解に向けたその場観察手法の検討”,第40回エレクトロニクス実装学会春季講演大会論文集,pp.538-539 (2025)
- 村田 夢実,巽 裕章,中村 郁仁,西川 宏,“Sn-3.0Ag-0.5Cuはんだ接合部における高温環境下での金属間化合物の成長挙動調査”,第40回エレクトロニクス実装学会春季講演大会論文集,pp.402-404 (2025)
- [Invited] 巽 裕章,“Cu-Si3N4絶縁回路基板の接合界面評価”,第40回エレクトロニクス実装学会春季講演大会論文集,pp349-351 (2025)
- 村田 夢実,巽 裕章,中村 郁仁,西川 宏,“冷却速度と高温放置がSn-3.0Ag-0.5Cuはんだの組織と硬度に及ぼす影響”,第40回エレクトロニクス実装学会春季講演大会論文集,pp.330-333 (2025)
- 林 雄二郎,Kim Jaemyung,矢橋 牧名,巽 裕章,“ダイアタッチはんだ接合における亜粒界増加の非破壊可視化”,第40回エレクトロニクス実装学会春季講演大会論文集,pp.168-171 (2025)
- 木村 翔星,巽 裕章,西川 宏,“温度サイクルによるダイアタッチはんだ接合部の結晶方位変化”,第40回エレクトロニクス実装学会春季講演大会論文集,pp.76-78 (2025)
2025
- 林 雄二郎,Kim Jaemyung,矢橋 牧名,巽 裕章,“ダイアタッチはんだ接合内部における亜粒界分布の非破壊可視化”,第35回マイクロエレクトロニクスシンポジウム(MES2025)論文集,pp.208-211 (2025)
- 村田 夢実,巽 裕章,中村 郁仁,西川 宏,“冷却速度と高温放置がSn-3.0Ag-0.5Cuはんだの組織と硬度に及ぼす影響”,第35回マイクロエレクトロニクスシンポジウム(MES2025)論文集,pp.299-302 (2025)
- 巽 裕章,新田 隼也,伊藤 篤史,高山 有道,高橋 誠,文 盛載,津島 栄樹,西川 宏,“Cu-Si3N4絶縁基板の接合界面評価”,第35回マイクロエレクトロニクスシンポジウム(MES2025)論文集,pp.320-322 (2025)
- 小野 涼翔,巽 裕章,西川 宏,“デジタル画像相関法を用いたAg粒子焼結体の変形挙動調査”,第35回マイクロエレクトロニクスシンポジウム(MES2025)論文集,pp.353-356 (2025)
- 川上 夏輝,巽 裕章,Tzu-hsuan Huang,Hsiu-mei Yang,Shih-kang Lin,西川宏,“ナノインデンテーションを用いたSn-Bi-Zn合金の変形挙動評価”,第39回エレクトロニクス実装学会春季講演大会論文集,pp.51-52 (2025)
- 林 雄二郎,Kim Jaemyung, 矢橋 牧名, 巽 裕章,“ダイアタッチはんだ接合の非破壊X線回折方位顕微鏡”,第39回エレクトロニクス実装学会春季講演大会論文集,pp.22-25 (2025)
- 新田 隼也,巽 裕章,西川 宏,“ナノインデンテーション試験を用いたSn-52 mass%In合金におけるクリープ変形挙動の温度依存性”,第31回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2025)論文集,pp.67-71 (2025)
- 内田 弘翔,巽 裕章,西川 宏,“Ag-Cu合金の脱合金化による表面Agナノポーラスシートの作製と接合性評価”,第31回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2025)論文集,pp.85-89 (2025)
- 川上 夏輝,巽 裕章,西川 宏,“Zn添加がSn-Bi系合金の変形挙動に及ぼす影響”,第31回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2025)論文集,pp.392-393 (2025)
- 平瀬 加奈,巽 裕章,西川 宏,“電解めっきポーラス銅/はんだ複合構造を有する接合部の作製”,第31回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2025)論文集,pp.394-395 (2025)
- 遠藤 柊翔,安藤 哲也,西川 宏,巽 裕章,“Agペースト焼結材のせん断強度に及ぼすせん断試験条件の影響”,第31回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2025)論文集,pp.398-399 (2025)
2024
- 平瀬 加奈,巽 裕章,西川 宏,“ロータス型ポーラス銅/はんだ複合接合部の熱伝導率評価”,第34回マイクロエレクトロニクスシンポジウム(MES2024)論文集,pp.123-126 (2024)
- 林 雄二郎,Kim Jaemyung,矢橋 牧名,巽 裕章,“冷熱サイクル試験前後のはんだ接合の非破壊大面積方位マッピング”,第34回マイクロエレクトロニクスシンポジウム(MES2024)論文集,pp.311-314 (2024)
- 川上 夏輝,巽 裕章,西川 宏,“Ni-P/AuめっきによるSn-Bi系合金バンプ継手特性評価”,第34回マイクロエレクトロニクスシンポジウム(MES2024)論文集,pp.317-320 (2024)
- 巽 裕章,C. R. Kao,西川 宏,“分子動力学法によるCu-Cu接合界面のボイド消失挙動の評価”,第34回マイクロエレクトロニクスシンポジウム(MES2024)論文集,pp.411-412 (2024)
- 内田弘翔,巽 裕章,西川 宏,“ダイアタッチに向けたAg-Cu合金の脱合金化によるAgナノポーラスシートの作製”,第38回エレクトロニクス実装学会春季講演大会論文集,pp.165-166 (2024)
- 林雄二郎,Kim Jaemyung,矢橋 牧名,巽 裕章,“放射光X線回折によるパワーモジュール向けはんだ接合の大面積非破壊方位マッピング”,第38回エレクトロニクス実装学会春季講演大会論文集,pp.266-269 (2024)
- 中脇 啓貴,巽 裕章,Chih-han Yang,Shih-kang Lin,西川 宏,“Sn-Bi-Zn-In合金の微細組織が変形挙動に及ぼす影響”,第30回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2024)論文集,pp.29-33 (2024)
- 貴田 優希,巽 裕章,竹中 啓輔,佐藤 雄二,塚本 雅裕,西川 宏,“青色半導体レーザを用いた純銅リボンはんだ付中の温度分布と微細組織の評価”,第30回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2024)論文集,pp.49-53 (2024)
- 巽 裕章,磯野 浩,平瀬 加奈,井手 拓哉,西川 宏,“ロータス型ポーラス銅・はんだ複合構造を活用した高放熱モジュールの試作評価”,第30回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2024)論文集,pp.112-113 (2024)
2023
- 新田 隼也,巽 裕章,西川 宏,“Sn-In/ZrO2ナノ粒子複合合金におけるナノ粒子表面の分散性への影響”,第33回マイクロエレクトロニクスシンポジウム(MES2023)論文集,pp.355-358 (2023)
- 貴田 優希,巽 裕章,竹中 啓輔,佐藤 雄二,塚本 雅裕,西川 宏,“青色半導体レーザを用いた純銅リボンはんだ付プロセスの短時間化”,第33回マイクロエレクトロニクスシンポジウム(MES2023)論文集,pp.291-294 (2023)
- 黒田 裕志,巽 裕章,西川 宏,“銀ナノ粒子ペースト焼結体のエレクトロマイグレーション現象における試験温度の影響”,第29回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2023)論文集,pp.90-93 (2023)
- 中脇 啓貴,巽 裕章,Chih-han Yang,Shih-kang Lin,西川 宏,“Sn-Bi-Zn-In合金の機械的特性に及ぼすBi添加量の影響”,第29回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2023)論文集,pp.132-133 (2023)
- 貴田 優希,巽 裕章,佐藤 雄二,塚本 雅裕,西川 宏,“青色半導体レーザ照射条件が純銅リボンのはんだ付継手特性に与える影響”,第29回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2023)論文集,pp.134-135 (2023)
- 淀 将悟,巽 裕章,西川 宏,“銀シートを用いた固相拡散接合の接合強度にシート内残留応力が及ぼす影響”,第29回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2023)論文集,pp.73-74 (2023)
2022
- 新田 隼也,巽 裕章,西川 宏,“表面改質したZrO2ナノ粒子を添加したSn-In合金の作製と評価”,第32回マイクロエレクトロニクスシンポジウム(MES2022)論文集,pp.199-202 (2022)
- 綿谷 一駿,朴 炳浩,巽 裕章,西川 宏,“ダイアタッチ用表面微細構造Cuシートの提案”,第28回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2022)論文集,pp.108-111 (2022)
- 金下 征司,佐藤 雄二,巽 裕章,塚本 雅裕,西川 宏,“レーザはんだ付におけるはんだ溶融挙動の観察と継手の特性評価”,第28回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2022)論文集,pp.84-87 (2022)
- 碓井 脩斗,松田 朋己,藤野 純司,巽 裕章,小椋 智,加柴 良裕,廣瀬 明夫,“酸化銀マイクロ粒子を用いた銀-アルミニウム接合の低温化”,第28回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2022)論文集,pp.42-43 (2022)
- 黒田 裕志,金 智,巽 裕章,西川 宏,“銀ナノペースト焼結体のエレクトロマイグレーション現象評価”,第28回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2022)論文集,pp.313-314 (2022)
2020
- 山際 大貴,松田 朋己,巽 裕章,佐野 智一,加柴 良裕,古澤 秀樹,佐藤 賢次,廣瀬 明夫,“サブミクロン銅粒子を用いた無加圧接合における焼結プロセスの検討”,第26回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2020)論文集,pp.323-328 (2020).
2018
- 巽 裕章,Adrian Lis,物種 武士,山口 博,加柴 良裕,廣瀬 明夫,“銅-はんだ-樹脂複合材を用いた液相拡散焼結法によるパワーモジュール向けダイアタッチ技術”,第28回マイクロエレクトロニクスシンポジウム(MES2018)論文集,pp.237-240 (2018).
2016
- 藤野 純司,坂元 創一,柳本 辰則,巽 裕章,増森 俊二,“パワー半導体の高温動作を可能にするアセンブリ技術”,第26回マイクロエレクトロニクスシンポジウム(MES2016)論文集,pp.155-158 (2016).
2015
- 巽 裕章,熊田 翔,福田 敦,山口 博,加柴 良裕,“銀ナノ粒子焼結接合部の信頼性に及ぼす機械的特性の影響”,第21回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2015)論文集,pp.75-80 (2015).
2010
- 西村 眞澄,小椋 智,巽 裕章,武田 直也,小中 洋輔,高原 渉,廣瀬 明夫,”分子動力学シミュレーションを用いた銀ナノ粒子と基材金属との界面接合過程の検討”,第16回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2010)論文集,pp.129-134 (2010).
2009
- 武田 直也,巽 裕章,赤田 裕亮,小椋 智,井出 英一,守田 俊章,廣瀬 明夫,“酸化銀マイクロ粒子を用いた銀ナノ粒子その場生成による新接合法”,第15回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2009)論文集,pp.195-200 (2009).
2008
- 赤田 祐亮,巽 裕章,山口 拓人,廣瀬 明夫,守田 俊章,井出 英一,“銀ナノ粒子接合における界面接合機構の検討”,第14回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2008)論文集,vol. 14,pp.179-184 (2008).
- 巽 裕章,赤田 祐亮,山口 拓人,廣瀬 明夫,“複合型銀ナノ粒子を用いた高温対応接合プロセス-接合性に及ぼす炭酸銀の影響”,第14回エレクトロニクスにおけるマイクロ接合・実装技術シンポジウム(Mate2008)論文集,vol. 14. pp.173-178 (2008).

